混合键合芯纪元——Besi引领3D封装革命(四)千亿资本角逐封装新战场
本文深度剖析荷兰半导体设备巨头Besi如何以混合键合技术撬动全球先进封装变革。面对AI与高性能计算芯片对3D集成的爆发性需求,传统封装技术已逼近物理极限。Besi凭借<10nm级键合精度与晶圆级集成方案,成为台积电SoIC、英特尔Foveros等尖端架构的核心赋能者。文章全景解析技术原理、产业链布局及商业落地路径,揭示Besi与应材结盟、卡位HBM/CPO市场的战略野心,更预判2026年476亿欧元市场爆发在即——这不仅关乎单点技术突破,更将重塑全球半导体制造权力格局。欢迎感兴趣的读者转发与关注!
BESI明确将混合键合定位为AI时代先进封装变革的核心引擎。无论是数据中心的高性能逻辑封装、HBM内存堆叠,还是CPO互连的实现,BESI的技术正迎来一个加速采用的重要转折点。随着摩尔定律在未来十年面临日益严峻的局限,混合键合与系统级封装的融合有望开启半导体创新的新篇章——而BESI正站在这一变革的最前沿。AI时代的先进封装:全球资本激增与BESI在供应链变革中的核心作用随着AI、高性能计算(HPC)和内存堆叠持续重塑半导体格局,先进封装已成为全球竞争的战场。根据BESI于2025年6月发布的数据,目前全球范围内计划或正在投入下一代先进封装晶圆厂的资本支出超过1000亿美元。这波投资浪潮凸显了行业的重大转向——将封装从传统的“后端”工序转变为系统级集成的核心。它也揭示了各大晶圆代工厂和封测代工厂(OSAT)为确保在AI时代领先地位而采取的战略举措。从地域和投资规模来看,台积电是扩大先进封装产能最激进的厂商之一。自2024年起,台积电启动了位于台湾嘉义的AP7晶圆厂,投资150亿美元专注于CoWoS和SoIC封装平台。同时,投资77亿美元的台南AP8晶圆厂正在建设中,以支持先进的2.5D和3D集成。在美国,台积电计划在2025年前于亚利桑那州破土动工一座先进封装厂,预计资本支出将达到100亿美元,以实现先进制程节点和3D封装的本地化集成。另一方面,英特尔(Intel)采取了多地点的策略以分散风险和资源。这包括马来西亚槟城(目前暂停)、波兰弗罗茨瓦夫(同样暂停)、美国新墨西哥州的Fab 11x(正在爬坡量产)以及计划于2025年在成都启动的新先进封装设施。这些工厂主要旨在使用混合键合技术组装先进逻辑芯片,并支持诸如EMIB和Foveros Omni等大型芯片封装——这对于AI CPU和GPU至关重要。随着高带宽内存(HBM)和共封装光学(CPO)成为AI架构的核心,韩国内存巨头SK海力士(SK Hynix)和三星(Samsung)正在迅速扩大规模。SK海力士正在美国印第安纳州投资39亿美元建设一座新的HBM封装厂,同时也在韩国扩建其M15工厂的生产线。与此同时,三星正在韩国天安市和美国德克萨斯州开发两个大型封装项目,投资额在40亿至81亿美元之间。这些努力将支持HBM4、3D堆叠和光子集成。在美国,美光(Micron)(在新加坡、印度和中国西安的总投资超过100亿美元)和格罗方德(GlobalFoundries)(纽约州)等公司正在提升其封装能力,以提供专为边缘AI和汽车应用量身定制的低延迟、高能效解决方案。台湾的封测代工领导者,如日月光(ASE)和矽品精密(SPIL),正加倍投入先进封装。矽品精密正在彰化、云林和台中后里扩产,重点关注倒装芯片(Flip Chip)、2.5D/3D模块和混合键合。日月光也在马来西亚槟城积极推进,与BESI及其他设备供应商合作,共同开发高良率的制造解决方案。在中国大陆,通富微电(TFME)、华天科技(Huatian)、长电科技(JCET)、华润微电子(SJ Semi - 长电科技子公司)和盛合晶微(HT Tech)等公司正在建设专注于晶圆级封装(WLP)、扇出型晶圆级封装(FOWLP)和共封装光学模块的先进封装产线。这些主要在2023年至2025年间启动的项目,投资额从1亿美元到3亿美元不等。在欧洲,意法半导体(STMicroelectronics)和Silicon Box于2024年启动了扩张计划,包括在意大利卡塔尼亚投资5亿美元的晶圆厂以及由Silicon Box主导的光子封装平台。德国和葡萄牙也在规划新项目,标志着欧洲正加紧进入下一代封装竞争。根据BESI的分析,这股封装投资热潮涵盖了所有主要的晶圆制造和封测代工生态系统,并且与AI、HBM、CPO、异构集成和边缘计算的兴起紧密相关。晶圆代工厂正在垂直整合封装能力,而封测代工厂和材料/设备供应商则同步升级生产线——目标是达到Class 1洁净室标准、亚微米级对准精度和自动化高吞吐量生产。随着摩尔定律放缓,先进封装有望接棒成为性能提升的新引擎。这张全球投资版图揭示了对由3D堆叠和混合键合引领的封装转型的集体拥抱,而BESI的设备解决方案正处在这场全行业重构的最核心位置。2.5D/3D封装快速增长:BESI加速高精度AI组装解决方案根据Yole Group 2024年12月的预测,全球先进封装市场正经历显著扩张——尤其是在2.5D和3D封装领域,预计未来几年它们将成为最具爆发性的应用类别。市场规模预计将从2024年的519亿美元增长至2028年的786亿美元,其中2.5D/3D封装将以18.9%的复合年增长率(CAGR)领先,远超其他先进封装技术7.8%的复合年增长率。作为半导体组装和键合设备的全球领导者,BE半导体工业公司(BESI)已将其产品组合战略性地聚焦于这一高增长领域,并已取得可观的市场份额和技术优势。随着生成式AI、高性能计算(HPC)、高带宽内存(HBM)和多芯片模块(MCM)的迅速兴起,对芯片间高密度、低延迟、高能效的数据传输需求日益增长。传统封装技术已不足以满足现代AI和计算系统的性能要求。2.5D封装通过硅中介层实现高速互连,而3D封装则利用混合键合垂直堆叠芯片,进一步推进集成度,提供超短信号路径、更高带宽和卓越的集成密度。这些架构被认为是未来AI芯片、共封装光学(CPO)模块和SoC-内存堆叠所必需的。因此,预计这些封装方法将在2026年至2028年间被大规模采用,推动设备和材料市场的爆发性增长。*原文媒体:Semi Version
*原文链接:
https://tspasemiconductor.substack.com/p/hybrid-bonding-at-scale-besis-vision
2025湾芯展-技术论坛预告(2025.10.15-10.17)
声明:本文内容及配图由入驻作者撰写或合作网站授权转载。文章观点仅代表作者本人,不代表科技区角网立场。仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
点击这里
 扫码添加微信
扫码添加微信




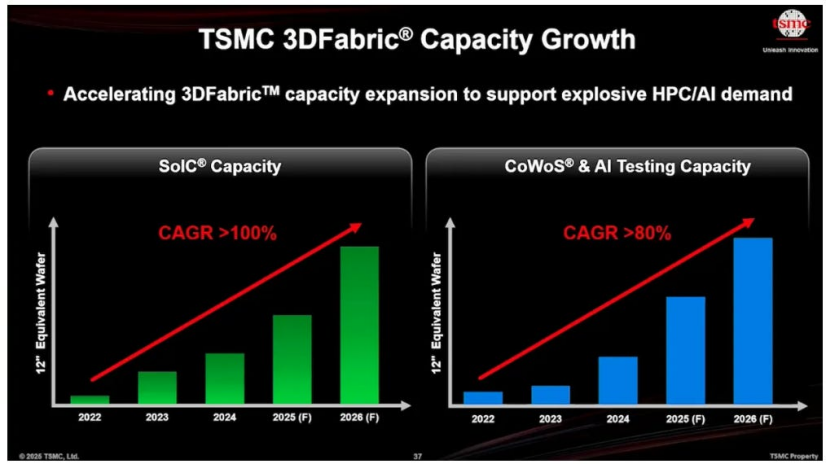










 扫码添加微信
扫码添加微信
 扫码添加微信
扫码添加微信
 扫码加入群聊
扫码加入群聊















