混合键合芯纪元——Besi引领3D封装革命(三)供应链全景与AI战略驱动下的技术拐点
- 2025-07-25 08:00:00

【编者按】
本文深度剖析荷兰半导体设备巨头Besi如何以混合键合技术撬动全球先进封装变革。面对AI与高性能计算芯片对3D集成的爆发性需求,传统封装技术已逼近物理极限。Besi凭借<10nm级键合精度与晶圆级集成方案,成为台积电SoIC、英特尔Foveros等尖端架构的核心赋能者。文章全景解析技术原理、产业链布局及商业落地路径,揭示Besi与应材结盟、卡位HBM/CPO市场的战略野心,更预判2026年476亿欧元市场爆发在即——这不仅关乎单点技术突破,更将重塑全球半导体制造权力格局。欢迎感兴趣的读者转发与关注!

顺便提一下,近期 IEEE ECTC 和 IEEE IITC 会议上,大量论文聚焦于混合键合(Hybrid Bonding)技术。台湾阳明交通大学(NYCU)的陈教授发表了利用铜/聚合物混合键合(Cu/Polymer Hybrid Bonding)的研究,而工研院(ITRI)在 ECTC 上则展示了一种通过再布线层(RDL)界面实现的新型聚合物基混合键合(Polymer-Based Hybrid Bonding)技术。值得注意的是,陈教授已在 IEEE 期刊上发表了大量关于 3DIC 封装的论文。未来,SemiVision 将对此类创新性学术工作进行深入分析。
BESI 与应用材料公司(AMAT)密切合作,也一直积极参与混合键合研究。在 IEEE IITC 上,BESI 和 AMAT 共同撰写了一篇专门针对晶粒对晶圆(Die-to-Wafer, D2W)混合键合的论文,突显了他们在推进下一代封装技术方面深厚的技术合作关系。




混合键合供应链:全球概览
作为一项突破互连密度和能效瓶颈的变革性技术,混合键合正迅速成为下一代半导体封装的基础层。以下是整个价值链中关键参与者的详细分类:
1.设备供应商
Besi (BE Semiconductor Industries)
·提供完整的晶圆对晶圆(Wafer-to-Wafer, W2W)和晶粒对晶圆(D2W)混合键合平台。
·专注于高精度对准和产能可扩展性。
·集成于 SoIC、HBM 和逻辑堆叠流程。
·与台积电(TSMC)、英特尔(Intel)、三星(Samsung)和博通(Broadcom)积极开展合作。
EV Group (EVG)
·全球 W2W 混合键合系统领导者。
·为台积电的 SoIC-L 和索尼(Sony)的图像传感器平台提供对准+键合设备。
·以在光学和 CIS(CMOS 图像传感器)应用中的优势而闻名。
佳能 Anelva (Canon ANELVA)
·专注于铜平坦化和界面清洗。
·致力于异构逻辑-存储器堆叠。
·与日本的 IDM(集成器件制造商)深度合作。
SUSS MicroTec
·开发低温键合和薄晶圆处理模块。
·在背面 IC 集成和精密微堆叠方面具有竞争力。
2.晶圆代工厂和先进封装供应商
台积电 (TSMC)
·全面部署 SoIC-W(晶圆级)、SoIC-X、SoIC-P 混合键合平台。
·CoWoS + SoIC 是核心 AI 封装架构。
·合作伙伴包括苹果(Apple)、AMD、博通(Broadcom)和英伟达(NVIDIA)。
英特尔 (Intel)
·拥有自主混合键合平台 Foveros Direct,可实现 0 微米间隙键合。
·应用于如 Clearwater Forest 和 Meteor Lake 等先进节点。
三星 (Samsung)
为 HBM4/HBM5 DRAM 堆栈寻求混合键合方案。
开发专有的异构逻辑-存储器集成流程。
3.材料和服务提供商
信越化学(Shin-Etsu)、JSR、杜邦(DuPont)
·供应键合界面材料:粘附层、介电质和绝缘材料。
·增强平坦化、表面活化和热传导性。
日月光(ASE)、安靠(Amkor)、矽品(SPIL)
·正在试点 D2W 混合键合产线。
·与 Besi 和 EVG 就认证和工艺集成进行合作。
在即将到来的先进封装浪潮中,混合键合不仅是一项技术创新——它更是平台集成能力、供应链领导地位和资本可扩展性的试金石。Besi 已不再仅仅是一家设备制造商;它已成为 AI 封装革命的“中枢神经系统”。
如果您希望理解这场技术变革背后的完整动态——从设备、代工厂、材料到实际应用——本文将为您提供驾驭下一个芯片设计和系统集成时代所必需的多维度洞察。



AI 时代的先进封装:BESI 对混合键合的战略押注
随着生成式 AI 的快速演进以及从云端到边缘的计算需求持续激增,全球超大规模数据中心运营商正在投入巨资扩展其高性能计算(HPC)基础设施。BE Semiconductor Industries (BESI) 将这股 AI 基础设施建设热潮视为先进封装技术大规模采用的直接催化剂,为混合键合等关键工艺创新释放了前所未有的增长机遇。
AI 扩张驱动先进封装创新

生成式 AI 的爆发式增长意味着 2026 年至 2030 年间对逻辑芯片、存储器和高带宽 I/O 系统的需求将急剧上升。为了支撑这些计算密集型应用——从云数据中心到消费级边缘 AI 设备——行业需要高性能、低功耗和高集成的封装解决方案。
BESI 强调,先进封装将成为实现 AI 性能潜力的核心赋能因素,是提高能效和计算密度的关键差异化要素。这种需求不仅限于大型云处理器,还将扩展到智能手机、AR/VR 头显、AI 摄像头和汽车电子等边缘设备,从而扩大先进封装和混合键合的总可寻址市场。
混合键合处于拐点
BESI 明确将混合键合视为实现维持摩尔定律所需的新型 2.5D 和 3D 组装架构的基础技术。全球主要逻辑芯片制造商已进入使用 3D 混合键合进行商业生产的早期阶段,旨在提升下一代数据中心处理器中 CPU、GPU 和存储器之间的集成度。
更值得注意的是,光电(OE)集成正成为混合键合的新前沿,特别是在共封装光学(Co-Packaged Optics, CPO)平台中。CPO 涉及将光收发器与交换机 ASIC 直接集成在同一封装内——这一过程需要超高互连密度和超低延迟。混合键合正迅速成为应对此类高频光电集成挑战的首选解决方案。
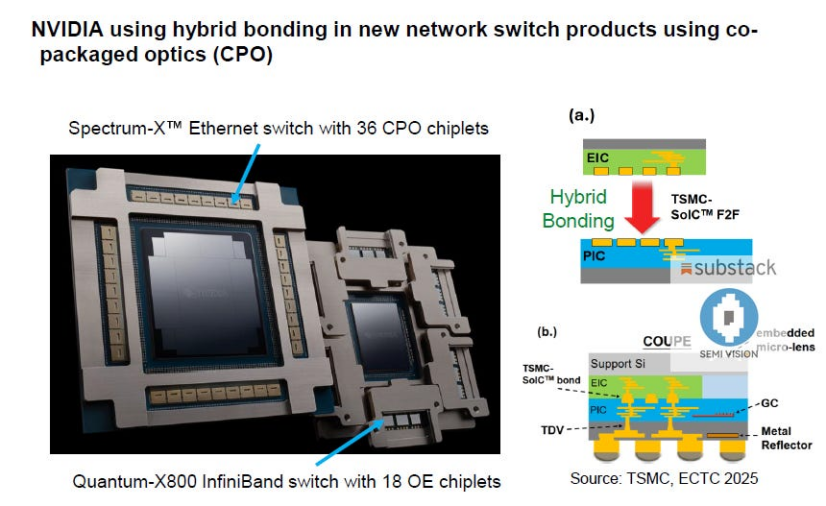
BESI 还强调了混合键合和下一代热压键合(TCB Next)在支持 HBM4/HBM5封装中的关键作用,这需要对信号完整性、热管理和堆叠良率进行极其严格的控制。

平台演进与战略路线图
BESI 持续推进其技术平台,以适应下一代封装不断变化的需求。其产品路线图现已包括对多种关键架构的支持,例如:
·CoWoS-L(局部硅互连)和 CoWoS-R(再布线层)
·用于先进热压键合的 TCB Next
·下一代倒装芯片(Flip Chip)技术
·用于复杂异构集成的多模块组装(Multi Module Assembly, MMA)
这些解决方案不仅专为高性能计算和 AI 芯片堆叠而设计,还将 BESI 定位为全行业封装转型的关键赋能者。通过此,BESI 正在将其影响力扩展到包括逻辑、存储器和光学模块在内的多样化应用领域。
*原文媒体:Semi Version
*原文链接:
https://tspasemiconductor.substack.com/p/hybrid-bonding-at-scale-besis-vision
相关阅读


芯启未来,智创生态




 扫码添加微信
扫码添加微信
- 点赞 (0)
-
分享
微信扫一扫
-
加入群聊
 扫码加入群聊
扫码加入群聊















