广东致能:全球首发硅基垂直 GaN HEMT 功率器件技术
- 2025-07-16 14:59:02

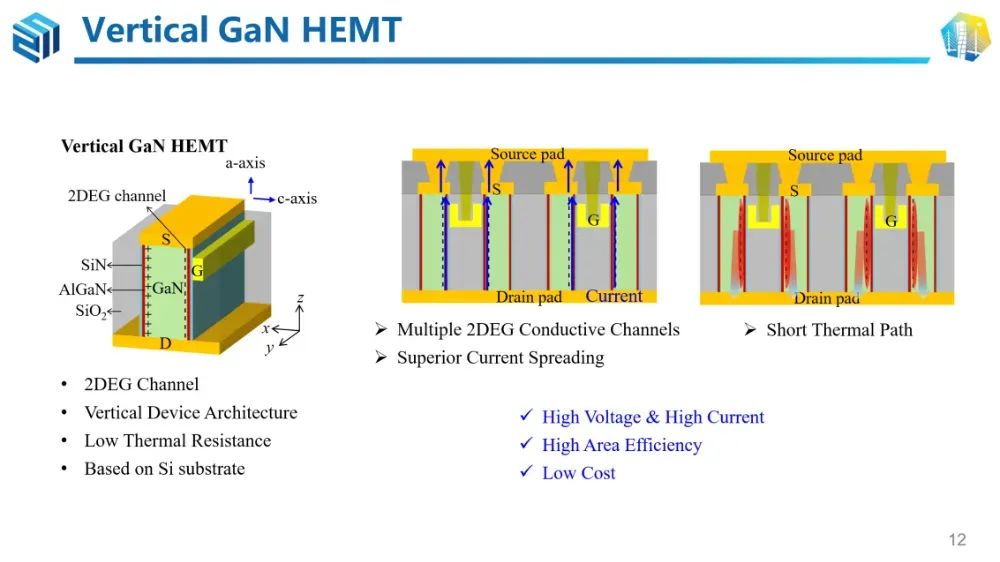


 图1 x-SEM 结构 图2 剥离硅衬底
图1 x-SEM 结构 图2 剥离硅衬底来源:广东致能
点击左下方阅读原文,立即报名第四届功率半导体与先进封装测试创新高峰论坛!

声明:本文内容及配图由入驻作者撰写或合作网站授权转载。文章观点仅代表作者本人,不代表科技区角网立场。仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
点击这里
 扫码添加微信
扫码添加微信
 扫码添加微信
扫码添加微信
- 点赞 0
-
分享
微信扫一扫
-
加入群聊
 扫码加入群聊
扫码加入群聊















